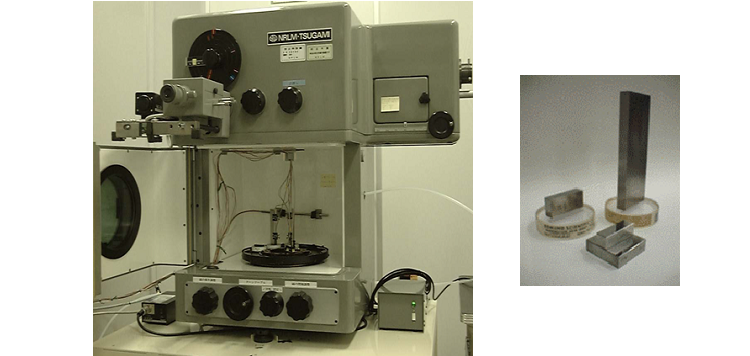
Gauge block interferometer
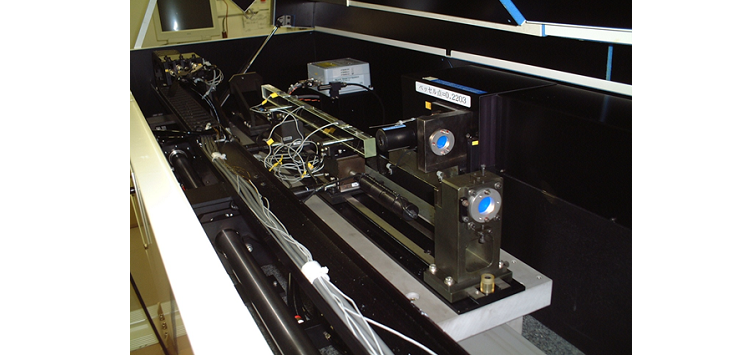
Laser interferometer for line scale calibration
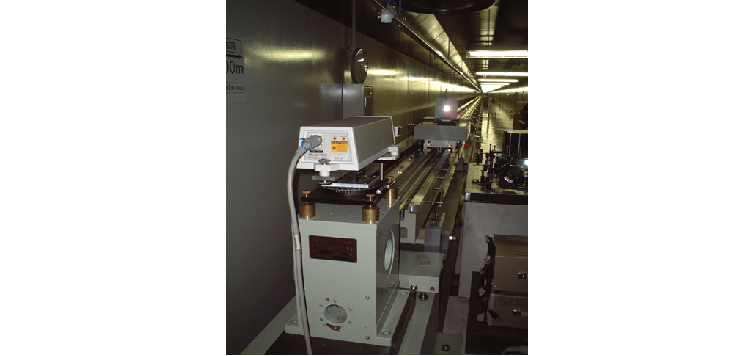
Optical tunnel
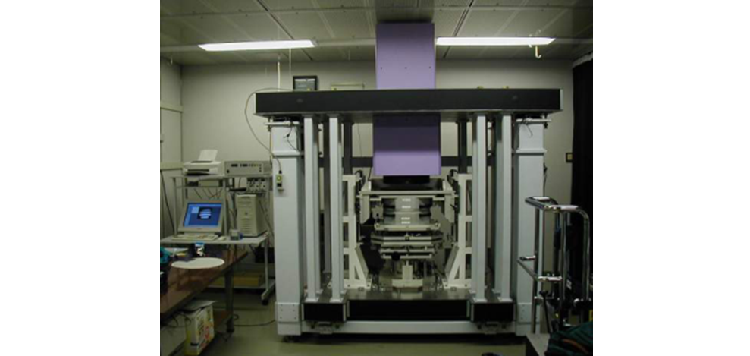
Fizeau interferometer for flatness calibration
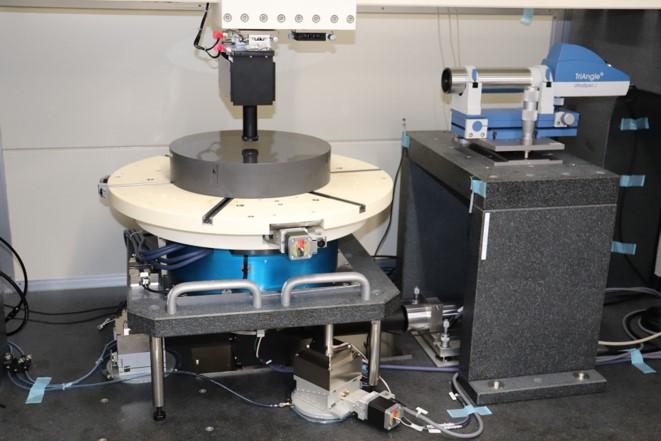
3-D scanning deflectometric profiler

Example of thickness distribution measurement of a silicon wafer

High-precision laser interferometer module with its nonlinearity less than 10 pm

Micro-coordinate measuring machine
Length Standards are foundation of industries and sciences. We at Length Standards Section devote ourselves to various tasks in order to establish metrological standards and calibration system in the area of length (gauge blocks, line scales, EDM, laser interferometer, step height), deviation (flatness, spherical degree), and refractive index metrology. We construct efficient hierarchical traceability system in cooperation with calibration laboratories. At the same time, we conduct research and development activities regarding advanced length measurement science and technology.
Research Themes
- Precise evaluation of the dimensional (length) change in the time for various types of low thermal expansion materials by utilizing the gauge block interferometer
- Development of a large aperture (over 600 mm) and high precision (5 nm) flatness calibration system by using the two-dimensional scanning deflectometric profiler.
- Development of a high precision diameter calibration system for the reference sphere used in μ-CMM.
- Development of a double-sided interferometer for SI-traceable thickness measurement such as of silicon wafer.
- Development of a laser interferometer module minimizing its nonlinearity to be less than 10 pm and implemented as a length standard in comparative verification for various types of displacement sensors.
- Development of a GI-SAXS instrument which aims to establish the SI-traceability and reliable calibration for pitch smaller than 100 nm of 1D grating samples.
Contact
Group leader
E-mail: <at> aist.go.jp
