ウェハプロセス研究チーム
ウェハプロセスチームでは主に、パワー半導体用SiCバルク単結晶の製造技術とそのウェハ加工技術の研究開発を行っています。ウェハ材料として大口径・高品質・低コストの3つの条件が求められますが、これらを兼ね備える材料・装置・プロセス・評価の4つの技術分野を結晶学から材料工学、精密工学まで連携し、次世代の材料技術の創生を目指してします。
重点研究
結晶成長(昇華法)の研究
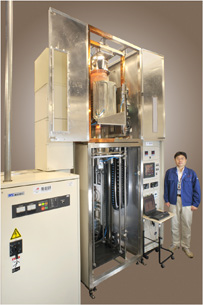
SiC原料粉体を黒鉛るつぼ中で2000度以上の高温で昇華させ、気相輸送で単結晶成長を行うのがSiCの昇華法成長です。大小複数の高周波加熱炉を有しており、6インチ超の大口径成長やコスト削減につながる高速成長技術の開発を行っています。また、伝導度制御を目的とした2ゾーン加熱炉を用いて、不純物ドーピング条件を制御する事で、SiCの超低抵抗n・p型結晶成長、低欠陥成長の技術開発も行っています。

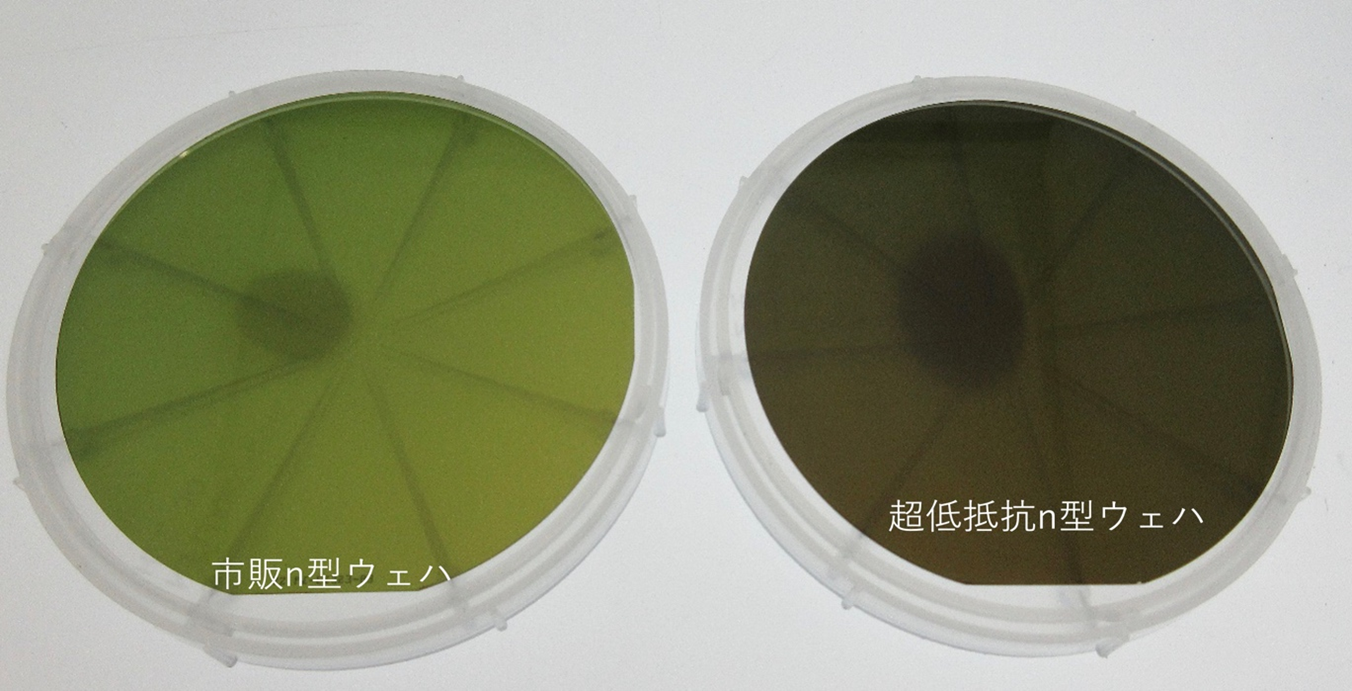
結晶成長(溶液法)の研究

2000℃程度に加熱されたSiとCを含む高温溶液からSiCを析出させる方法が溶液成長法です。この方法は原理的に低欠陥密度の高品質結晶の育成に有利であり、新たな結晶育成法として期待されています。溶液中のC濃度を大きくしてSiC成長速度を大きくしつつ、ステップバンチングと呼ばれる成長界面の荒れを抑制することがこの成長手法の研究開発の主題です。様々な溶液組成を結晶成長実験を通じて検討し、熱対流シミュレーションなどを活用しながら高品質・低コストを実現する溶液成長技術の開発を進めています。 また複数の結晶成長技術を有する産総研の強みを活かし、溶液成長法と昇華法を組み合わせ簡便な方法にて欠陥低減が可能な“ハイブリッド成長”の技術開発も行っています。
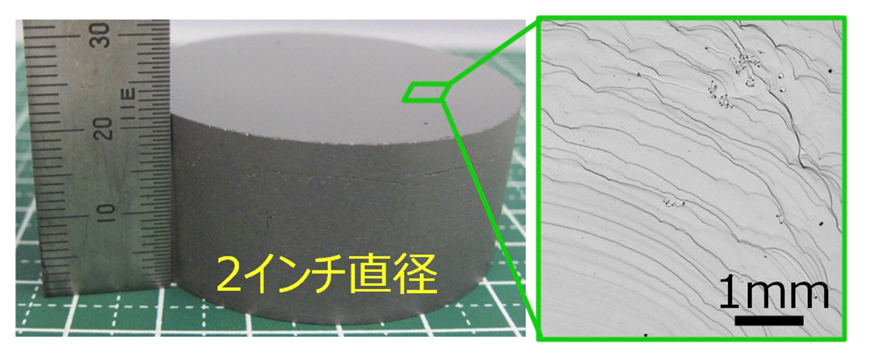
ウェハ加工の研究
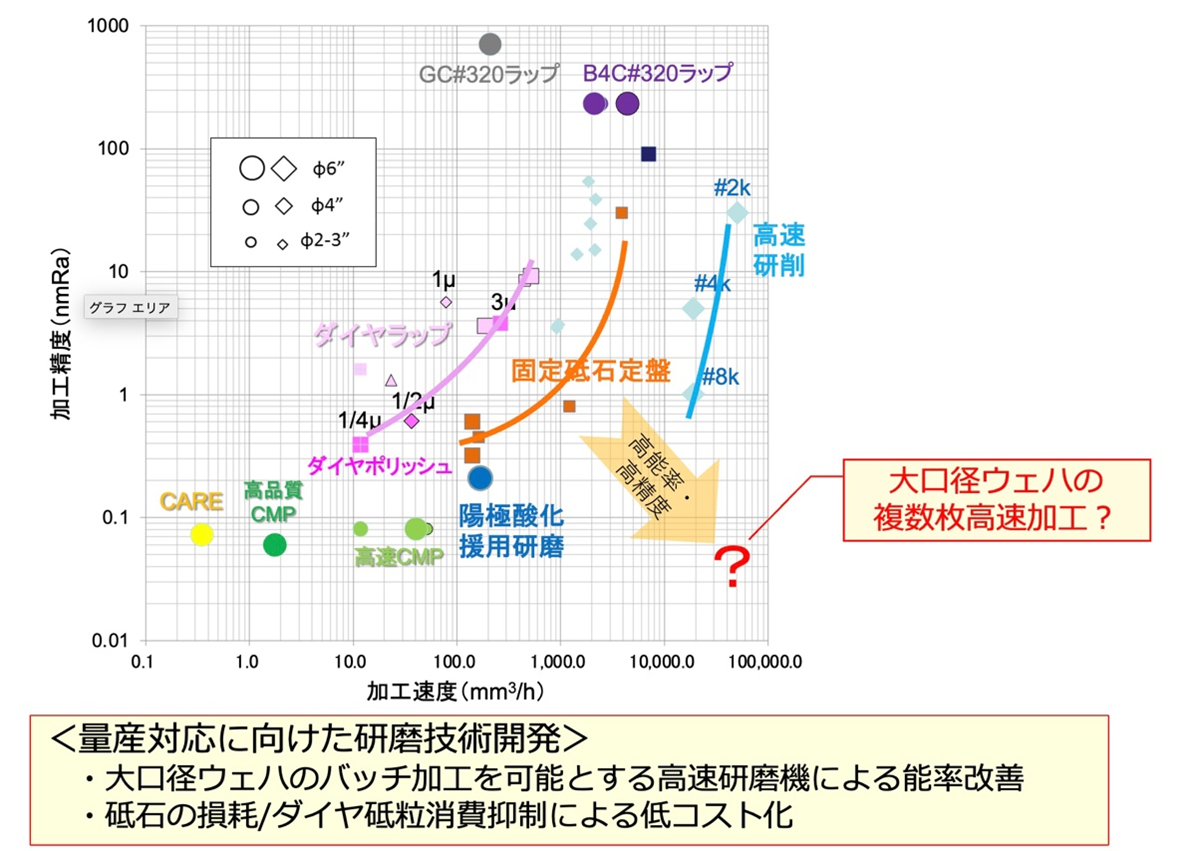
固くて脆いSiC単結晶はウェハに加工するにも長い時間とコストがかかる工程です。切断、研磨、研削などの工程には高価なダイヤモンド砥材を必要とします。当グループでは高品質化を低コスト化を両立する新しいウェハ加工技術の開発を行っております。できるだけダイヤモンドを使わず、しかも短時間で終えられるウェハ加工工程の完成を目指しています。
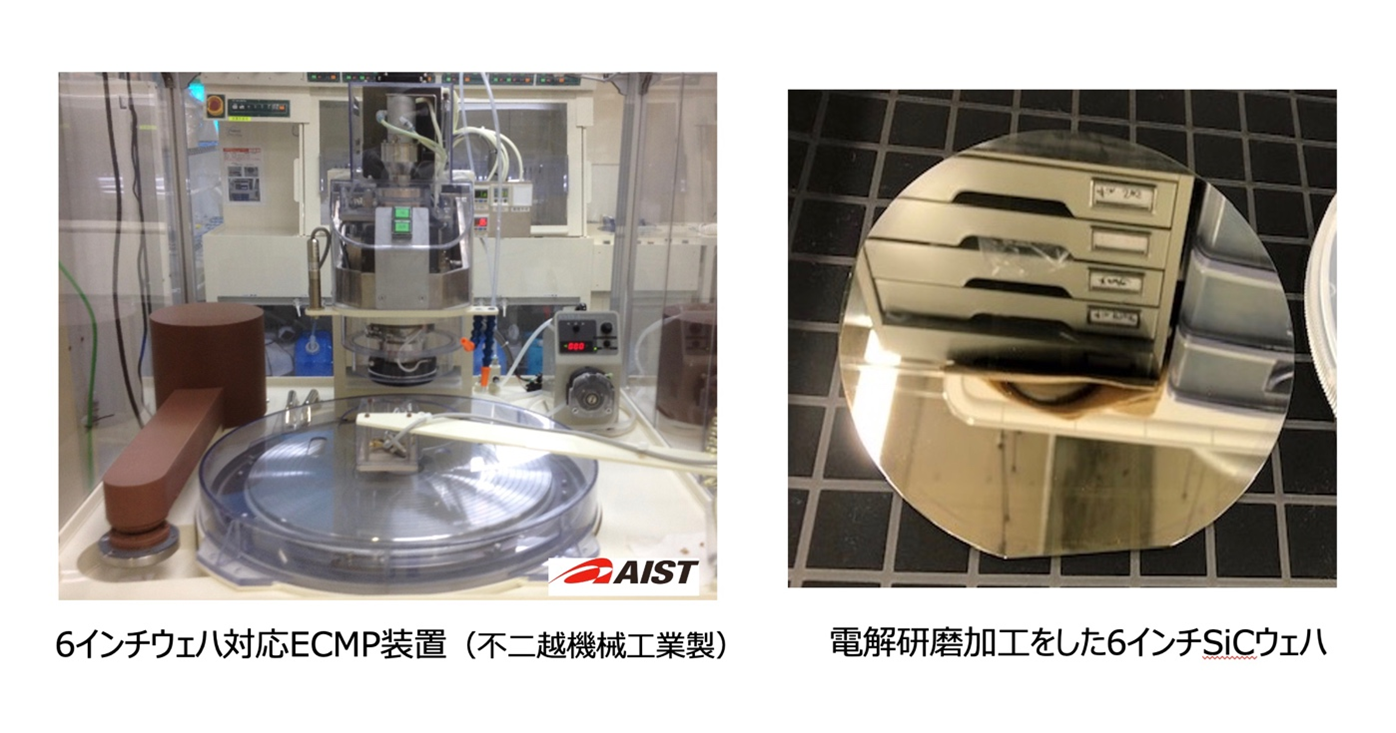
TPECでの産学官連携開発の推進


民活型共同研究体「TPEC」において、2019年より新しく材料分科会を設立しました。(詳細はここ)主に、SiCバルク単結晶成長とウェハ加工技術、ウェハ評価技術に関する研究開発を互いに連接することで、世界に先駆け大口径・高品質・低コストを両立するSiCウェハ量産技術の確立を目指しています。
保有技術
- 大口径SiC成長
- 高速SiC成長
- 高濃度不純物ドーピングSiC成長技術
- 低抵抗n型・p型SiCバルク単結晶成長
- 低欠陥SiC成長技術
- 大口径SiC高速加工技術
- ウェハ評価技術
主要特許・論文
- K. Eto, H. Suo, T. Kato, H. Okumura,“Growth of P-type 4H–SiC single crystals by physical vapor transport using aluminum and nitrogen co-doping”, J. Cryst. Growth, 470, (2017) 154–158. https://doi.org/10.1016/j.jcrysgro.2017.04.025>
- H. Suo, K. Eto, T. Ise, Y. Tokuda, H. Osawa, H. Tsuchida, T. Kato, H. Okumura, “Difference of double Shockley-type stacking faults expansion in highly nitrogen-doped and nitrogen-boron co-doped n-type 4H-SiC crystals”, J. Cryst. Growth, 468, (2017) 879–882. https://doi.org/10.1016/j.jcrysgro.2016.12.055
- T. Kato, K. Eto, S. Takagi, T. Miura, Y. Urakami, H. Kondo, F. Hirose, H. Okumura, “Growth of low resistivity n-type 4H-SiC bulk crystals by sublimation method using co-doping technique”, Mater. Sci. Forum, 778-780, (2014) 47-50. https://doi.org/10.4028/www.scientific.net/MSF.778-780.47
- Takeshi Mitani, Kazuma Eto, Kenji Momose, Tomohisa Kato, “Massive reduction of threading screw dislocations in 4H-SiC crystals grown by a hybrid method combined with solution growth and physical vapor transport growth on higher off-angle substrates”, Applied Physics Express, 14 (2021) 085506. https://doi.org/10.35848/1882-0786/ac15c1
- 三谷武志、小松直佳、加藤智久、「4H-SiC溶液成長でのマクロステップ形状と溶媒組成の関係」、日本結晶成長学会誌45巻(2018)45-2-02 https://doi.org/10.19009/jjacg.3-45-2-02.
- Takeshi Mitani, Naoyoshi Komatsu, Tetsuo Takahashi, Tomohisa Kato, Shunta Harada, Toru Ujihara, Yuji Matsumoto, Kazuhisa Kurashige, Hajime Okumura, “Effect of aluminum addition on the surface step morphology of 4H-SiC grown from Si-Cr-C solution”, Journal of Crystal Growth, 423 (2015) 45. https://doi.org/10.1016/j.jcrysgro.2015.04.032
- Takeshi Mitani, Naoyoshi Komatsu, Tetsuo Takahashi, Tomohisa Kato, Kuniharu Fujii, Toru Ujihara, Yuji Matsumoto, Kazuhisa Kurashige, Hajime Okumura, “Growth rate and surface morphology of 4H-SiC crystals grown from Si-Cr-C and Si-Cr-Al-C solutions under various temperature gradient conditions”, Journal of Crystal Growth, 401 (2014) 681. https://doi.org/10.1016/j.jcrysgro.2013.11.031
- 加藤智久、「総論:パワーデバイス用SiCウェーハの加工技術」、Journal of the Japan Society for Abrasive Technology Vol.61 No.8 (2017) 418-421.
- 特許第6755524号 「p型4H-SiC単結晶及びp型4H-SiC単結晶の製造方法」
- 特許第6757955号 「n型SiC単結晶基板及びその製造方法、並びにSiCエピタキシャルウェハ」