第53回情報計測オンラインセミナー「半導体微細パターンのラフネス形状計測とノイズを含むデータの解析」(木津)
|
目次 1.計量標準に基づくナノ構造の寸法・形状計測 2.半導体製造における微細パターンのラフネス計測:背景,課題①:LERの理解のための3D計測技術,課題②:ノイズ起因誤差の正確な理解 3.まとめ 詳細はこちら |
単細胞藻類 Pseudococcomyxa simplex におけるヘキサクロロ白金(IV)イオンの取り込みと蓄積機構(Metallomics誌)(共著:熊谷)
|
ヘキサクロロ白金酸(IV)溶液を単細胞藻類Pseudococcomyxa simplexに添加することにより、白金の取り込みを調べました。 白金溶液([Pt] = 100 mg/kg、pH 3.2 ~ 3.4)を一定時間添加した後、細胞を急速凍結し、シンクロトロン X 線を用いた μ-XRF(蛍光 X 線)分析を行いました。 約 1 マイクロメートルのビーム サイズにより、単一セル内の白金の分布を視覚化できます。 一方、酵素処理したプロトプラストや凍結乾燥細胞における白金の取り込みを調べたところ、これらのサンプル中の白金取り込み濃度は生体内細胞よりも高いことが分かりました。 細胞壁と細胞代謝は、ヘキサクロロ白金酸(IV)イオンの取り込みを妨げると推定されています。 細胞に取り込まれた白金イオンはすべて二価の形に還元されました。 白金の添加に対する光の影響も調査されました。 明るい条件下で白金を添加すると、一部のサンプルは日陰の条件下よりも高い白金の蓄積を示しました。
詳細はこちら |
電子ビーム誘起収縮によるフォトレジスト側壁粗さの変化の原子間力顕微鏡を用いた評価 (J. of Micro/Nanopatterning, Materials, and Metrology)(木津・三隅)
|
背景:走査電子顕微鏡 (SEM) は、ラインエッジラフネス (LER) の測定に一般的に使用されます。 ただし、電子ビーム (EB) 露光では材料の収縮が発生するため、このアプローチではフォトレジストの高精度 LER 測定を達成することは困難です。 さらに、収縮前後の 3D 側壁形状の違いが詳細に調査されていません。 目的:EB 露光によって引き起こされるフォトレジストの収縮がパターンの側壁の粗さに及ぼす影響を評価することです。 アプローチ:探針傾斜技術を備えた原子間力顕微鏡(tilting-AFM)を使用して、EB露光の前後にフォトレジストパターンを測定することによって、収縮が観察されました。 結果:EB露光により表面の粗さが滑らかになり、上部の角が丸くなり、パターンの高さが低くなります。 LER 解析によって評価された粗さパラメータは、収縮に伴って標準偏差 (σ) と粗さ指数 (α) が減少する一方、相関長 (ξ) が増加することを示しました。 結論:SEM ベースの LER 測定ではEB による収縮の影響によりσ と α が過小評価され、ξ が過大評価される可能性があることを示しています。 我々はEB 損傷を発生させずに、高分解能かつ低ノイズでフォトレジストパターンの 3D 形状を評価するtilting-AFM 技術を確立しました。 詳細はこちら |
300 kV での透過電子顕微鏡による格子イメージングに使用可能な Si の試料厚さの実験的評価(Ultramicroscopy誌)(小林・木津)
|
オリジナルの標準物質 (RM) を使用しさまざまな厚さの RM の Si パターンから得られた格子画像を比較することにより、相補型金属酸化物半導体カメラを備え300 kV で動作する透過電子顕微鏡 (TEM) 装置での格子イメージングに使用可能な Si の試料の厚さを評価しました。厚さ508nmまでのパターンで結晶Siの{111}面の格子像を観察することに成功しました。しかしながら、厚さ508 nmの格子縞のコントラストは厚さ316 nm以下のパターンの格子像を取得するのに必要な露光時間 (0.5 秒) よりも長い露光時間 (5.0 秒) を使用して記録した場合でも、明確ではありませんでした。これらの結果に基づき、正確な構造解析と格子イメージングによるTEM倍率校正のための結晶Si試料の実用的な厚さは、実験条件下で約 500 nm 未満であると結論付けました。
詳細はこちら |
超低エネルギー走査電子顕微鏡における0 eV付近着地エネルギーでのコントラスト機構(Microscopy誌)(共著:熊谷)
|
近年、数keV以下の低い着地エネルギーで走査電子顕微鏡(SEM)観察を行う手法が一般的になってきました。 特に0 eV付近での急激なコントラスト変化に注目しました。 Si、Ni、Ptからなるパターンサンプルを用いて、入射電子の全反射が起こる閾値エネルギーを0 eV付近でSEMで調べました。 in-situ と ex-situ のサンプル洗浄の両方の場合において、各材料の輝度の劇的な変化が 0 eV 付近で観察され、しきい値エネルギーは Si < Ni < Pt の順でした。 この順序は、ケルビン力プローブ顕微鏡によって測定された仕事関数および表面電位の文献値の順序と一致しました。 この結果は、しきい値エネルギーの違いが、各材料の仕事関数の違いによる表面電位の違いによって生じていることを示唆しています。しきい値エネルギーの順序は文献で報告されている仕事関数の順序とも一致していますが、空気にさらされた表面の仕事関数は、吸着物などによって大幅に変化する可能性があるため、むしろ「修正された仕事関数」として考慮される必要があります。それにもかかわらず、市販のSEMでは0 eV付近の着地エネルギーで各材料の閾値エネルギーの違いが観察され、材料を区別する新たな可能性が開かれました。ただし、表面電位は表面処理や大気暴露の条件に影響されやすいため、違いはむしろ「指紋」として認識されるべきです。
詳細はこちら |
自己アフィンフラクタルの粗さ測定におけるホワイトノイズの影響(Measurement Science and Technology誌)(木津・三隅)
|
本研究では、自己アフィンフラクタルの粗さ解析を通して、パワースペクトル密度(PSD)と高さ-高さ相関関数(HHCF)におけるノイズに関連した誤差項の表現を定式化し明らかにしました。本研究では、ノイズをホワイトノイズと仮定し、半導体リソグラフィ技術に関わるラインエッジラフネス測定という典型的な状況において、ノイズを含む粗さプロファイルのPSDとHHCFをシミュレートしました。その結果、従来のノイズ補正技術では、ノイズに起因する残留誤差を考慮していないため、PSD/HHCFが真の粗さプロファイルのものから偏る可能性があることがわかりました。粗さ解析とシミュレーション技術から得られた知見は、特定の状況における定量的な残留誤差の解明、最適な解析手法(PSDまたはHHCF)の選択、ノイズ誤差を十分に小さくするために必要な平均化プロファイル(測定)数の推定、ノイズ低減戦略の検討など、さまざまな応用に役立つことが期待されます。
詳細はこちら |
次世代機能性マイクロ・ナノ構造のためのラインエッジラフネス参照標準の開発フレームワーク(Precision Engineering誌)(木津・三隅)
|
リソグラフィで作製されたマイクロ/ナノスケールのラインパターンのエッジは、設計通りの直線ではなく、粗さがあります。これはラインエッジラフネス(LER)と呼ばれ、デバイスの性能に関わる重要な寸法情報であり、リソグラフィ関連技術の基礎研究において、既知のLER値を含む参照標準が必要です。我々は、必要な特性を含むLER参照標準を開発するための新しいフレームワークを提案します。提案するフレームワークは、3つの主要な特徴を持ちます: (i)次世代デバイス開発のための自己アフィンフラクタル粗さモデル、(ii)SIトレーサブル原子間力顕微鏡(AFM)を用いたLER参照標準測定に基づく信頼性の高い評価方法、(iii)従来のAFMベースのLER参照標準測定で検証した走査電子顕微鏡ベースのLER計測による汎用性のある評価方法。提案したフレームワークを検証するための実験として、電子ビームリソグラフィを用いてLER参照標準を作製しました。その結果、提案したフレームワークは、次世代機能性マイクロ・ナノ構造のLER参照標準の開発に利用できることがわかりました。
詳細はこちら |
傾斜探針型測長AFMによるフォトレジストの収縮観察(Proc. SPIE)(木津・三隅)
|
走査電子顕微鏡(SEM)はラインエッジラフネス(LER)測定によく使われますが、フォトレジストは電子ビーム(EB)照射により材料が収縮するため、高精度のLER測定を行うことが困難です。また、収縮前後の3次元側壁形状の違いについては、これまで詳細に検討されていませんでした。本研究では、EBによるフォトレジストの収縮を、パターンの垂直方向の側壁を高精度に観察できる傾斜探針型測長AFMを用いて観察しました。実験では、同じフォトレジストパターンに対して、EB露光前と露光後(SEM観察)に傾斜探針型測長AFMで測定し、収縮変形を観察しました。その結果、EB露光により側壁が平滑化されることがわかりました。さらに、LER(粗さパラメータ)の変化傾向も観察されました。本測定技術は、フォトレジスト材料の理解を深めるとともに、SEMによるLER測定の改良に利用できます。
詳細はこちら |
単細胞藻類内部でテルル酸塩とテルル鉱石を還元して生成したテルルナノロッド(Chemistry Letters誌)(共著:熊谷)
|
単細胞藻類Pseudococcomyxa simplexにテルルのオキソアニオンを添加すると、テルルが高蓄積されることがわかりました。テルルは細胞内に取り込まれる際に還元され、細胞内に金属テルルのナノロッド(200-600 nm)が形成されました。化学的前処理を施していない細胞の電子顕微鏡観察では、細胞内のテルルナノロッドの存在を直接観察することができました。
詳細はこちら |
傾斜探針型原子間力顕微鏡を用いたフォトレジスト3次元側壁測定の高精度化(Journal of Applied Physics誌)(木津・三隅)
|
半導体デバイス製造のための先端リソグラフィ技術では、フォトレジストのラインパターンの側壁の粗さ(LER:Line-edge Roughness)の低減が重要な課題です。我々は、原子間力顕微鏡(AFM)を用いてレジストパターンの側壁を測定する技術を開発し、3次元(3D)、高分解能、低ノイズ、非破壊の測定を可能にしました。従来の走査電子顕微鏡(SEM)を用いたLER測定技術では、電子ビーム照射によるレジストパターンの収縮が発生していましたが、本AFM技術では、電子ビーム照射による収縮を原理的に回避することが可能です。このAFM技術は、従来のAFM技術では困難であった垂直な側壁を鋭いAFM探針で走査できる探針傾斜機構を採用しているため、3次元計測が可能です。また、AFM探針の変位計測にはレーザ干渉計を搭載し、高分解能・高精度・低ノイズを実現しています。この技術により、従来のSEM測定の課題であった低解像度、ノイズ、破壊的な測定などの問題を克服しています。また、3次元側壁粗さの観察、定量的な解析が可能となります。例えば、今回の実験では、レジスト側壁に数十nmの粒形状がランダムに形成され、裾引き形状がほとんどないことが確認されました。側壁のプロファイルを高さ分解能1 nmで解析することで、各高さにおける粗さ(自己アフィンフラクタル)パラメータを得ることができます。このように、AFMを用いたレジスト側壁の計測技術は、次世代半導体デバイス製造におけるレジストパターニングや関連するプロセス技術に重要な知見を与えることができます。
詳細はこちら |
SEM像のシャープネス評価および倍率校正用認証標準物質の不確かさ低減のための標準ナノスケールピッチ校正(Surface Topography: Metrology and Properties誌)(三隅・熊谷・木津)
|
走査電子顕微鏡(SEM)は、表面上のナノ構造を観察・解析するために広く用いられています。SEMで正確かつシャープな画像を得るためには、SEM画像のシャープネス評価と倍率校正を同時に行う必要があります。NMIJ-CRM 5207-aは、SEM画像のシャープネス評価と倍率校正のための認証標準物質です。NMIJ-CRM 5207-aの認証値は、X軸とY軸の平均ピッチです。NMIJ-CRM 5207-aの主な不確かさ要因は、市販の標準ナノスケールのピッチ校正です。本研究では、標準ナノスケールのピッチ校正値の不確かさを低減するために、測長原子間力顕微鏡を用いてピッチ校正を行い、その不確かさを評価しました。
詳細はこちら |
接触式エアリアル表面粗さ測定の技術動向―測長原子間力顕微鏡を用いた事例― (トライボロジスト)(三隅)
|
従来の接触式表面粗さ測定機でのプロファイル測定で得られる情報は「線」からの情報ですが、原子間力顕微鏡(AFM)画像を用いることで「面」からの表面粗さ情報を取得可能となります。本稿では、AFMによるプロファイル表面粗さ基準の校正、およびエアリアル表面粗さ測定の最新技術動向を解説します。
詳細はこちら |
単細胞緑藻類Chlamydomonas reinhardtiiにおける生物起源テルルナノロッドの形成 (Metallomics誌)(共著:熊谷・小林)
|
テルル(Te)は工業的に有用な元素ですが、環境汚染の原因となります。Te-BgNRは毒性の低いTeを高密度に含むため、植物中での生物由来Teナノロッド(Te-BgNR)の形成は、Teのファイトレメディエーションに関連するTeの無害化経路の一つであると考えられています。単細胞緑藻類である Chlamydomonas reinhardtii において、電子顕微鏡観察により不溶性Teは棒状の元素状Te、すなわちTe-BgNRであり、高結晶性のナノ構造であることが明らかになりました。藻類細胞はテルラートを代謝して可溶性のTe化合物を形成し、代謝しきれなかった余剰のテルラートは、テルラートよりも毒性の低いTe-BgNRに変換されたことが示唆されました。この結果は、C. reinhardtiiにおけるBgNRの形成を介したTe浄化の新たなアプローチとなります。
詳細はこちら |
技術で未来拓く 産総研の挑戦(232)パターン側壁の可視化 (日刊工業新聞)(木津)
|
詳細はこちら |
精密な粗さパラメータ測定のためのプロファイル平均化法を用いた偏りのないラインエッジラフネス測定 (J. of Micro/Nanopatterning, Materials, and Metrology (JM3誌))(木津・三隅)
|
背景:走査電子顕微鏡(SEM)ベースのラインエッジラフネス(LER)測定は、SEM画像のノイズによるエラーの影響を受けます。偏りのない粗さの結果を得るためにノイズ補正方法が開発されましたが、測定精度の観点からは依然として懸念があります。 目的:高精度のLER測定のための偏りのない粗さ分析を開発することです。 アプローチ:従来のバイアスのない粗さ分析とプロファイル平均化法を組み合わせます。この方法では、ラインパターンが繰り返し測定され、取得されたプロファイルが位置合わせされて平均化されます。 SEMで測定された実験結果は、SEMよりも信頼性の高い原子間力顕微鏡(AFM)ベースのLER計測を使用して検証されました。 結果:実験的評価は、提案された方法が従来の方法よりも正確に粗さパラメータを取得できることを示しました。 結論:SEMによるラインエッジプロファイルのノイズが大きすぎる場合、正確な粗さの結果を得るには、事前にノイズを低減してから粗さ分析を実行する必要があります。提案手法により、SEMを用いてLERを最高精度で測定することができます。さらに、AFMベースのLER計測は、SEMベースのLER計測のパフォーマンスを評価するための実行可能な手法として実証されました。 詳細はこちら |
Si試料の格子面間隔変動に及ぼす透過電子顕微鏡法用試料処理の影響 (Ultramicroscopy誌)(小林・三隅)
|
透過電子顕微鏡(TEM)用試料加工によるSiの(220)格子面間隔の変化を、破砕加工、機械研磨のみ、機械研磨とArイオン研磨を組み合わせた結晶試料の格子面間隔の測定値を比較することにより、実験的に評価しました。破砕法、機械研磨法、機械研磨法では、Siの(220)格子面間隔に明確な変化は見られませんでしたが、機械研磨法とArイオン研磨法を組み合わせた試料では、Arイオンビーム照射時間が長くなると(220)格子面間隔が大きくなる傾向がありました。また、加工方法によらず、試料端の最外周から測定した(220)格子面間隔は、内側から測定した格子面間隔よりも約3%~5%大きい傾向にあることが分かりました。これらの結果は,Si 試料の加工条件と Si 格子間隔の測定位置の違いが,Si 格子面間隔で倍率校正する TEM によるサブナノメートル計測の不確かさの主要因となり得ることを示すものです.また、サブナノメートル計測における TEM の倍率校正に Si の格子間隔を国際単位系へのトレーサビリティを確保した基準として適用しようとすると、試料加工による格子間隔のばらつきの影響が無視できないことが示唆されました。
詳細はこちら |
認証標準物質 NMIJ CRM 5207-a タングステンドットアレイの活用事例紹介:
タングステンドットアレイCRMを用いた共焦点ラマン分光顕微鏡の横分解能の高信頼評価 (Analytical Sciences誌)
|
共焦点ラマン顕微鏡は、サブマイクロメートルスケールで物理的および化学的情報を提供するため、さまざまなアプリケーションで広く使用されています。高品質の画像を得るには、共焦点ラマン顕微鏡の高い横方向の解像度が不可欠です。認証標準物質(NMIJ CRM 5207-a)Si基板上のタングステンドットアレイ(600 nmピッチ)を使用して、さまざまなピンホールサイズでの共焦点ラマン顕微鏡の横方向の解像度を評価しました。 xピッチとyピッチのマッピングスケールの精度は、Si信号プロファイルから確認され、横方向の解像度は、認証標準物質のスケールインジケータを使用した直定規法によって評価されました。これらの手順は、一般的な仕様(532 nmレーザ、100倍の対物レンズ、開口数0.9、ステップサイズ0.1μm)を備えた他の共焦点ラマン顕微鏡に適用できるため、共焦点ラマン顕微鏡の横方向分解能の高信頼な評価やマッピングスケール精度の日常管理に適しています。
詳細はこちら |
ヒト肝細胞癌HepG2細胞における生体性セレン化水銀ナノ粒子の形成メカニズムと毒性学的意義 (Chem. Res. Toxicol.誌)(共著:熊谷・小林)
|
水銀(Hg)の毒性は、さまざまな生物にセレン(Se)化合物を同時に投与することで軽減されることが広く認識されています。この研究では、ヒト肝細胞癌HepG2細胞における無機Hg(Hg2+)毒性に対する亜セレン酸ナトリウム(Na2SeO3)の拮抗作用の根底にあるメカニズムを明らかにしました。透過電子顕微鏡による観察は、直径100 nmまでのHgSe(チエマナイト)顆粒が細胞内のリソソーム様構造に蓄積されたことを示しました。 HgSe顆粒は、それぞれ直径10 nm未満の多数のHgSeナノ粒子で構成されていました。化学的に合成されたHgSeナノ粒子に曝露された細胞では、リソソームにHgSeナノ粒子の蓄積は観察されませんでした。これは、細胞内HgSeナノ粒子が、細胞内に輸送されたNa2SeO3およびHg2+イオンから生物学的に生成され、細胞外液で形成されたHgSeナノ粒子に由来しないことを示唆しています。培養72時間後、生体HgSeの約85%が細胞内に残っており、生体HgSeが細胞からほとんど排泄されなかったことを示しています。さらに、Hg2+の細胞毒性は、不溶性HgSeナノ粒子が形成される前でもNa2SeO3に同時に曝露することで改善されました。私たちのデータは、HepG2細胞がHg2+と還元型Se(セレニド)との直接相互作用によりHg2+の毒性を回避し、細胞内のHg–Se可溶性複合体を介してHgSeナノ粒子を形成できることを初めて確認しました。生体HgSeナノ粒子は、Hg解毒プロセスにおける究極の代謝物と見なされています。
詳細はこちら |
半導体リソグラフィ技術評価のためのラインエッジラフネス計測 (NMIJニュースレター第14号 4ページ) (木津・三隅)
|
NMIJでは、傾斜探針機構を備えた測長原子間力顕微鏡(傾斜探針型測長AFM)によるLER計測技術を開発しています。本装置では高分解能レーザ干渉計を用いた正確かつ低ノイズな形状計測に加え、AFM探針を傾斜させることでパターン側壁の三次元的な形状計測が可能になりました。
詳細はこちら |
産総研計量標準総合センターにおけるナノ構造計測標準の研究開発の動向(Nanomanufacturing and Metrology誌)(三隅・木津・井藤・熊谷・小林・重藤)
|
ナノテクノロジーの進歩に伴い、ナノ構造計測標準の重要性が高まっています。 ナノ構造計測標準を実現するには、複数の種類の高精度顕微鏡技術が必要です。 産総研計量標準総合センター(NMIJ)は、原子間力顕微鏡、透過電子顕微鏡、走査電子顕微鏡を使用してナノ構造計測標準を開発しています。 NMIJにおけるナノ構造計測標準の現状を紹介します。
詳細はこちら |
測長原子間力顕微鏡を用いたエアリアル表面粗さ測定のための探針検定方法の拡張(Measurement: Sensors誌)(三隅)
|
近年、原子間力顕微鏡(AFM)を用いた従来のプロファイル表面粗さ測定だけでなく、エアリアル表面粗さ測定への要求も高まっています。 本研究では、ISO 19606:2017で規定されている従来のプロファイル粗さ測定法をエアリアル表面粗さ測定まで拡張するために、エアリアル表面粗さパラメータ使用する手法を提案します。
詳細はこちら |
測長原子間力顕微鏡を用いた段差標準の校正(精密工学会誌)(三隅)
|
段差標準は、半導体デバイス検査装置の高さ方向の校正に用いられ、横方向の校正に用いられるピッチ標準とともに、最も基本的なナノ構造計測標準の一つです。筆者はこれまで、XYZ軸にレーザ干渉計を搭載した原子間力顕微鏡(測長AFM)を用いて段差やピッチの校正業務に従事してきました。しかしながらマイクロメートルオーダの段差と比較してナノメートルオーダの段差は、スケールファクタ(測定精度と実行スケールの比)の推定値がピッチと比較して一桁大きい、つまり不確かさが一桁程度大きいことが報告されており、また基準線の測定値の信頼性が段差の校正値に影響するなど、ナノメートルオーダの段差標準校正特有の難しさがあります。今回、ナノメートルオーダの段差標準の校正における留意点を解説します。
詳細はこちら |
スマートウィンドウアプリケーション向けの発色性アモルファスMoO3–xナノシートとそのナノ構造フィルム(ACS Applied Nano Materials)(共著・熊谷)
|
厚さ約1.5 nmのアモルファス三酸化モリブデン(a-MoO3–x)ナノシートは、層状のモリブデン酸ナトリウムNa0.9Mo2O4の剥離からソフト化学的に得られた2次元MoO2ナノシートの疑似トポタクティック反応によって合成されました。成長したままのMoO2ナノシートから結晶性MoO3–xナノシートへのトポタクティック相転移は、空気中200°Cでの簡便な焼成によって引き起こされました。シート構造に大きな変化を伴わないアモルファス化が250°Cで発生し、a-MoO3–xナノシートが生成されました。生成物の中で、a-MoO3–xナノシートの単層膜は、着色効率の点で、MoO3関連材料で構成される従来の薄膜と比較して、バンドギャップ励起による可視および赤外範囲で優れたフォトクロミック特性を示しました。この研究で製造されたa-MoO3–xナノ構造フィルムの着色効率は、アモルファス構造が電子正孔対の再結合を阻害したため、前駆体ナノシートの積層数が増加したにもかかわらず変化しませんでした。 さらに、多層構造は、ナノシート間に層間ギャラリーを有していました。 その結果、同様のa-MoO3–xナノ構造の層を含む厚膜は、顕著な程度の着色と、着色および漂白サイクルの再現性を示し、スマートウィンドウアプリケーションの可能性を示しています。
詳細はこちら |
透過電子顕微鏡による測長技術開発の動向(計測と制御)(小林)
|
透過電子顕微鏡(TEM)はその高い空間分解能から、他の顕微法の分解能を超えた微細構造の寸法測長へと広く応用されています。特に半導体の製造現場においては、集積回路の構造の測長にTEMは既に利用されています。TEMを用いたサブナノ・ナノメートルオーダーの測長が実務として現に行われ、また今後も発展することが期待される現状にもかかわらず、TEMによる測長にはこれまで倍率校正に用いるスケールにSIトレーサビリティが確保されていない問題がありました。そこで現在、TEMによる測長のSIトレーサビリティの確保に向けた研究が進められています。本報告書は、TEMによるサブナノ・ナノメートルオーダーの測長技術発展のための研究指針を立てるために行われた、TEMで行われる測長の現状の調査研究をまとめたものです。
詳細はこちら |
透過電子顕微鏡によるナノ物質の測長に関する調査研究(産総研計量標準報告)(小林)
|
透過電子顕微鏡(TEM)は、その高い空間分解能により、ナノメートルオーダでの寸法測定に広く適用されています。 著者は、ナノメートルからサブナノメートルのオーダでの計測技術を開発するための新しい研究テーマを探索するため、TEMを使用したナノメトロロジーの確立に関する先行研究を調査しました。 最近の研究では、SIトレーサビリティを実現するためのレーザ光波長の代替ルートとしてシリコンの格子間隔を使用することにより、SIトレーサブルなナノメトロロジーが実質的に10 nmから100 nmのオーダで確立されたことが報告されました。従来の研究とは対照的に、著者は、TEMによるナノからサブナノメートルのオーダでSIトレーサブルな計測技術を確立するために、TEM操作、操作環境、およびサンプル準備による倍率校正の不確かさの要因をさらに調査および評価する必要があることを説明しています。
詳細はこちら |
透過電子顕微鏡を用いたサブナノメートル計測における不確かさの実験的評価(Measurement Science and Technology誌)(小林・三隅)
|
透過電子顕微鏡(TEM)を用いたサブナノメートル計測における倍率変動による不確かさが、様々な条件下で取得された結晶Si試料の(220)格子間隔の測定値を比較することによって実験的に評価されました。実験的な評価の結果、主な不確かさ成分は日中の倍率変動、試料構造の不均一性を含む日中の再現性、中間レンズの磁気ヒステリシス、および投影レンズの歪みであることが明らかになりました。これらの成分の中で、日中の倍率変動を毎日の倍率校正によって無視できるレベルに抑えることが可能です。さらに、すべての測定の前に適切な参照物質(結晶Siの格子縞など)を用いた倍率校正により、試料がTEMシステムに導入された場合でも、3.2%の相対不確かさでサブナノメートルの計測が可能になることがわかりました。
詳細はこちら |
測長原子間力顕微鏡及び他の計測装置によるナノ構造計測標準(IOP ebooks)(三隅)
 |
ナノ計測装置の校正に用いられるナノ構造計測標準と、測長原子間力顕微鏡(測長AFM)および他の校正装置によるナノ構造計測標準の校正方法について述べています。最初にナノ構造計測標準の概要を示し、一次元および二次元グレーティングのピッチ標準、段差標準、線幅標準、標準ナノ粒子サイズ、およびAFM式表面粗さ測定について紹介しています。
詳細はこちら |
傾斜探針型測長原子間力顕微鏡を用いたSEMベースのラインエッジラフネス測定の評価(SPIE Proceedings)(木津・三隅)
|
本研究では、走査電子顕微鏡(SEM)ベースのラインエッジラフネス(LER)計測を評価する方法を開発しました。 LER参照計測として傾斜探針型測長原子間力顕微鏡(tilting-mAFM)を使用しました。 平均化と不偏補正法を組み合わせたSEMラインエッジプロファイルの高さ-高さ相関関数(HHCF)を分析しました。tilting-mAFMと直接比較することで、SEMベースのLER計測の正確な評価が可能になりました。 偏りのないHHCFと適切な条件での平均化方法の組み合わせにより、3つの粗さパラメータの比較的正確な測定が可能になることを示しました。 正確な粗さ評価を行うには、HHCF分析と偏りのない補正を実行する前に、ラインエッジプロファイルのノイズを低減することが重要であることがわかりました。
詳細はこちら |
ドットアレイ認証標準物質を用いたSEM像歪評価(Microscopy誌)(熊谷)
|
この論文では、認証標準物質(CRM)を試験片として使用して、走査電子顕微鏡(SEM)で画像の歪みを評価するための迅速で簡単な方法を紹介します。 CRMは正方形のドット配列構造を持ち、そのドットピッチは認定された値を持っています。 画像解析によりCRMの各ドット間の距離を計算することにより、ドット間隔の変化として画像の歪みを検出できます。 さらに、認証値の不確かさを考慮することにより、画像の歪みの重要性を定量的に評価することができます。 この方法により、画像の歪みから不確かさを簡単に推定でき、SEMによる測定の信頼性を向上させることができます。
詳細はこちら |
SEMおよび参照計測用傾斜探針型測長原子間力顕微鏡法によるラインエッジラフネス測定の直接比較 (J. of Micro/Nanolithography, MEMS, and MOEMS (JM3誌))(木津・三隅)
|
背景:古典的なラインエッジラフネス(LER)測定技術である2Dトップビュー計測に使用される従来の走査電子顕微鏡(SEM)は、ナノスケールのラインパターンの3D構造を測定することができません。 LER測定の場合、SEM測定では、3D側壁の粗さに対して単一のラインエッジプロファイルが生成されますが、ラインエッジプロファイルは3D側壁の高さごとに異なります。 目的:SEMベースのLER測定技術の評価方法を開発し、3D側壁形状がSEMの2D結果にどのように反映されるかを検証します。 アプローチ:SEMおよび原子間力顕微鏡(AFM)により、3D側壁を測定できる探針傾斜技術を使用して、ラインパターンの同一の位置を測定することによる直接比較を行います。ラインパターンは、その製造プロセスのために、側壁に縦縞があります。測定されたラインエッジプロファイルは、パワースペクトル密度、高さ-高さ相関関数、および自己相関関数を使用して分析されました。 結果:SEMとAFMで測定されたラインエッジプロファイルは、ノイズレベルを除いてよく一致していました。周波数およびスケーリング分析は、SEMプロファイルが高ノイズを含み、AFMとは対照的に自己アフィンフラクタルの特性を失っていることを示しました。 結論:側壁に縦縞のあるラインパターンの場合、SEMプロファイルは一般に3D側壁形状と一致しています。 AFMベースのLER測定手法は、他のLER測定手法を評価するためのLER参照計測として役立ちます。 詳細はこちら |
NMIJ CRM 5207の開発-走査電子顕微鏡の像シャープネス評価のためのタングステンドットアレイ-構造評価とドットピッチの決定(Microscopy誌)(熊谷)
|
走査電子顕微鏡(SEM)の像シャープネス評価と倍率校正用の新しい認定標準物質(CRM)を開発しました。 微分法による像シャープネス評価に適した設計のCRMは、シリコン基板上にナノスケールのタングステンドットアレイ構造が作製され、SEM画像のドットから基板への急峻なコントラスト遷移を実現します。 ドットアレイのピッチは、SEMの倍率校正に利用でき、SIトレーサブルに測定されました(相対拡張不確かさ:約1.3%)。 画像形成パラメータの1つである試料は、像シャープネスの値に影響を与えやすいため、「ピン留めされた試料」としてのCRMは、像シャープネス測定システムを実現するために重要な役割を果たします。
詳細はこちら |
誘導結合プラズマ質量分析によるニンニク中のテルル生体ナノ粒子の解明(Journal of Trace Elements in Medicine and Biology)(熊谷・小林)
|
テルル(Te)は生物にとって必須ではなく、有益ではなく、有毒な要素ですが、ニンニク(Allium sativum)は同化によってTeを蓄積し、テルロアミノ酸を含む有機テルル化合物を生成できると報告されています。 本研究では、ニンニクにおける不溶性Teナノ粒子の形成のための新しいTe代謝経路を明らかにしました。 Te生体ナノ粒子は生物に対して無毒であるため、それらの形成は、無機Teの解毒および有機テルル化合物の合成のための重要な代謝経路である可能性があります。 さらに、ニンニクは環境中のTeのファイトレメディエーションにうまく適用できます。
詳細はこちら |
測長原子間力顕微鏡を用いた表面粗さ測定における探針検定用試料 (Measurement Science and Technology誌)(三隅・木津)
|
近年、測長原子間力顕微鏡(測長AFM)が表面粗さ測定に使用されています。産総研計量標準総合センター(NMIJ)は、ISO 19606:2017に基づき、測長AFMを用いてプロファイル表面粗さ校正サービスを提供しています。このISO規格では、表面粗さ測定を行う前に、針状のスパイクを備えた探針検定用試料を用いて、プローブ先端の直径Dと粗さ測定の誤差を評価する必要があります。ただし、従来の探針検定用試料にはいくつかの問題があります:(1)針状のスパイクが高すぎる、(2)スパイク間の距離が長すぎる、(3)スパイクの曲率半径がAFM探針と比較して十分に小さいサイズではない。探針検定に由来する不確かさが大きくなる可能性があります。本研究では、探針の直径評価の候補として、従来とは別の市販の探針検定用試料を検討しました。繰り返し走査による探針の摩耗を防ぐために、スパイクの高さが低く、スパイク間の距離が短くなっています。本研究は、過大評価された探針検定に由来する不確かさが、新しい探針検定用試料を用いることによって是正できることを示しました。
詳細はこちら |
傾斜探針型測長原子間力顕微鏡を用いた参照計測用の垂直側壁ラインエッジラフネス測定 (J. of Micro/Nanolithography, MEMS, and MOEMS (JM3誌))(木津・三隅)
|
ラインエッジラフネス(LER)測定は、3次元デバイス構造の計測における課題の1つであり、LER参照計測は、信頼性の高いLER測定にとって重要です。 LER参照計測を目的として、ラインパターンの高さに沿ったLER分布を高い解像度と再現性で分析できるLER測定手法を開発しました。ラインパターンの垂直側壁の高解像度原子間力顕微鏡(AFM)画像は、SIトレーサブルな寸法測定を提供する傾斜探針型測長AFMを使用して取得されました。傾斜先端は傾斜サーボ軸で制御され、垂直サンプリングを高いサンプリング密度でラインパターンに沿って走査し、側壁でのLER高さ分布の分析を可能にしました。側壁の水平断面は、サブnmの解像度で側壁の粗さを示しています。側壁プロファイルのパワースペクトル密度(PSD)分析により、高周波領域のPSDノイズは、典型的な走査電子顕微鏡法のノイズよりも数桁低いことがわかりました。 AFM測定は、LER測定の再現性を評価するために3回連続して繰り返されました。結果は、各高さでのLERの標準偏差として評価された0.07 nmの高い再現性を示しました。
詳細はこちら |
サブナノメートル精度で原子間力顕微鏡の非線形ドリフトを補正するための参照走査法 (Measurement Science and Technology誌)(木津・三隅)
|
原子間力顕微鏡(AFM)の既知の基本的な問題は、AFM測定中にドリフトが発生し、AFM画像が歪むことです。本研究では、2次元(垂直軸と2つの水平軸のうちの1つ)の非線形ドリフトを補正する方法を提案し、実証します。通常のAFM測定は、ラスタースキャン方式を使用して、多くの高速スキャンプロファイルで実行されます。提案したドリフト補正方法では、最初にスキャンされたプロファイルが参照プロファイルとして設定され、通常のプロファイルスキャン中に最初にスキャンされた場所でのスキャンが定期的に挿入されます。通常のスキャンされたプロファイルは、ドリフトによって歪んだ通常のAFM画像を作成するために使用されます。時間に依存するドリフト距離は、スキャンされた一連の参照プロファイルによって推定でき、歪んだAFM画像はこの推定距離を使用して補正されます。実験の結果、2次元のドリフト補正は、サブナノメートルスケールで高い分解能と再現性の両方を備えていることが明らかになりました。
詳細はこちら |
ナノ粒子サイズ比較測定 (Metrologia誌)(三隅)
|
この比較測定では、10 nmから300 nmの範囲のサイズの3つの異なる材料(Au 10 nm、Ag 20 nm、PSL 30 nm、100 nm、300 nm)のナノ粒子を使用しました。 原子間力顕微鏡(AFM)、透過電子顕微鏡(TEM)、走査電子顕微鏡(SEM)、動的光散乱(DLS)、微分移動度分析(DMA)、小角X線散乱などのさまざまな方法で測定されました。
詳細はこちら |
サブナノオーダの表面粗さ校正のためのトレーサブル原子間力顕微鏡(LST-AFM) -LST-AFMの概要と温度安定性-(精密工学会誌)(三隅・木津)
|
差動式測長原子間力顕微鏡(DLI-AFM)を用いたプロファイル表面粗さ(Ra:0.2 nm〜100 nm)の校正技術が、産総研NMIJで開発されました。近年、サブナノメートルオーダの表面粗さ校正サービスのニーズが高まっています。 しかしながら、DLI-AFMを用いたサブナノメートルオーダの表面粗さ校正では、走査の安定性やドリフトなど、いくつかの解決するべき課題があります。 現在、サブナノメートルオーダの表面粗さ校正をより小さな不確かさで校正するべく、長さ標準にトレーサブルな測長AFM(LST-AFM)を開発しています。 このLST-AFMでは、より安定した表面粗さ校正を実現するために、Z軸干渉計の参照ミラーがAFMカンチレバープローブユニットに取り付けられています。 LST-AFMの概要、温度の安定性、AFM光学レバーシステムの光源について、報告します。
詳細はこちら |
走査電子顕微鏡による金ナノ粒子懸濁液の数濃度の測定(Metrologia誌)(熊谷)
|
懸濁液中のナノ粒子(NP)の数濃度(NC)を測定することは、医療および工業製品の品質と有効性の指標として使用されるため重要になりました。走査電子顕微鏡(SEM)は個々の粒子を明らかにすることができますが、サンプルの準備が困難なため、測定には一般的に使用されません。マイクロ液体ディスペンサーを使用して金NP懸濁液の試料を調製し、SEMと重量測定を組み合わせてNCを測定しました。ディスペンサーは、飛散することなくSi基板上に懸濁液の小さな液滴を置き、小さな領域に粒子を閉じ込めます。この方法により、SEMでその領域内のすべての粒子を損失なく観察およびカウントすることができました。液滴の平均重量は、分析天びんのディスペンサーからリザーバーへの複数の噴射の重量増分から決定されました。 NP数を単一の液滴重量で除算すると、単位g−1のNCが得られます。液滴内のすべての粒子を特定することにより、金NPのNCを正確に測定し、相対拡張不確かさ<6% (k = 2)で測定できました。
詳細はこちら |
測長原子間力顕微鏡を用いたプロファイル表面粗さ測定の範囲の拡張(Precision Engineering誌)(三隅・木津)
|
測長原子間力顕微鏡を用いたプロファイル表面粗さの校正を行っています。表面粗さRaの校正範囲が約0.2 nm〜100 nmに拡張されました。これは精密機械加工および半導体産業からの要求に応えるために行われました。
詳細はこちら |
SEMによるナノ計測を支える認証標準物質(NMIJ研究トピックス)(熊谷)
|
走査電子顕微鏡画像の像分解能(ボケ量)を評価するための認証標準物質「NMIJ CRM 5207-a タングステンドットアレイ」を開発しました。このCRMはシリコン基板上にタングステンドットが格子状に並んだ構造をもち、認証値であるドットピッチにより電子顕微鏡の倍率校正を、また、そのドットエッジを利用しDR法による分解能評価を行うことができます。本CRMを用いた簡便な分解能評価法は、装置性能評価をはじめ、装置の状態管理や客観的なオペレータ習熟度評価への応用に期待がもたれます。
詳細はこちら |
傾斜探針機構搭載型測長原子力顕微鏡を用いた線幅校正 (Measurement Science and Technology誌)(木津・三隅)
|
傾斜探針機構搭載型測長原子力顕微鏡(tilting-mAFM)を用いて、ナノスケールラインパターンの線幅または臨界寸法(CD)を校正しました。 傾倒探針は、ラインパターンの垂直側壁の走査を可能にします。 tilting-mAFMを用いてラインパターンの各側で2回の測定を行い、2つのデータセットのスティッチングを行い、ラインパターンの完全な形状を再構成します。 さらに、このパターンに基づいてCDを測定します。 このCD校正手順を検証するために、サブナノメートルスケールの不確かさを有する線幅標準を測定試料として使用しました。tilting-mAFMを用いて校正されたCDは111.2 nmであり、拡張不確かさが1.0 nmでした。これは傾斜のAFMを用いて報告されたCD測定の間で観察された最小の不確かさでした。さらに、このCD値とCD参照値との差はわずか0.2 nmでした。 この結果は、tilting-mAFMがシングルナノメートルの精度でCD計測に使用できることを示しています。
詳細はこちら |
原子間力顕微鏡における空間寸法:計測器、エフェクト、計測 (Ultramicroscopy誌)(三隅)
|
空間次元に関するAFMおよび測定の分類の枠組みを提示します。また、CD-AFM / 2D-AFMのための幾何学的および動的探針-試料相互作用のモデルも提示します。探針-試料相互作用およびサンプリングドリフトにおける走査軸アーチファクトの役割について説明します。さらに測定モデルの入力と出力に関して、AFM測定における空間次元と測定量の定義の影響について説明します。
詳細はこちら |
三次元ナノ構造の寸法・形状計測技術に関する調査研究(産総研 計量標準報告)(木津)
|
半導体デバイス上のナノ構造は、近年、二次元から三次元へと進化してきました。 線幅は、半導体デバイスの3Dナノ構造の最も基本的なパラメータであり、製造における寸法制御に使用されます。 本報告では、3次元ナノ構造の寸法や形状、特に線幅についての典型的な測定技術を概説します。 NMIJを含む国家計量研究所間で行なわれた線幅測定国際比較のパイロット研究を紹介します。 最後に、NMIJが提供する線幅(パターン寸法)校正サービス、3Dナノ構造の寸法と形状測定技術の将来の展望を示します。
詳細はこちら |
3Dナノ計測用 傾斜探針型測長原子間力顕微鏡の開発 (Measurement Science and Technology誌)(木津)
|
垂直側壁の表面における高分解能トポグラフィ測定、およびナノデバイス線幅のトレーサブル測定のため、3Dナノ計測機能を拡張した傾斜探針機構を備えた測長原子間力顕微鏡(tilting-mAFM)が開発されています。tiliting-mAFMにおいて、プローブ先端は、プローブ先端がナノメートルスケール構造の垂直側壁に接触して辿ることができるように、垂直から最大16°まで傾斜しています。一方、従来の原子間力顕微鏡のプローブは、有限の円錐角のために垂直面に到達することができません。プローブの変位は、長さのSI単位にトレーサブルな高分解能レーザ干渉計を用いて3軸で測定されます。平行ばね構造の中心対称3Dスキャナは、非常に低い軸間クロストークでプローブ走査を可能にします。垂直側壁を走査する独自の技術も開発され、適用されました。実験結果は、走査プロファイルおよび側壁角度測定における高い再現性を示しました。さらに、ラインパターンの3D測定が実証され、両方の側壁からのデータがサブナノメートルの精度で結合されました。
詳細はこちら |
測長原子間力顕微鏡を用いた標準ナノ粒子のサイズ測定と不確かさ評価(Precision Engineering誌)(三隅)
|
測長原子間力顕微鏡を用いて標準ナノ粒子のサイズ測定を行い、不確かさを評価しました。塑性変形を仮定して、粒子と基板との間で生じる粒子の変形量を算出し、粒子の変形に由来する不確かさも評価しました。さらに測定結果を、他の顕微鏡法による結果と比較しました。
詳細はこちら |
回折式ピッチ校正システムの校正・測定能力の再評価(IJAT誌)(三隅・木津)
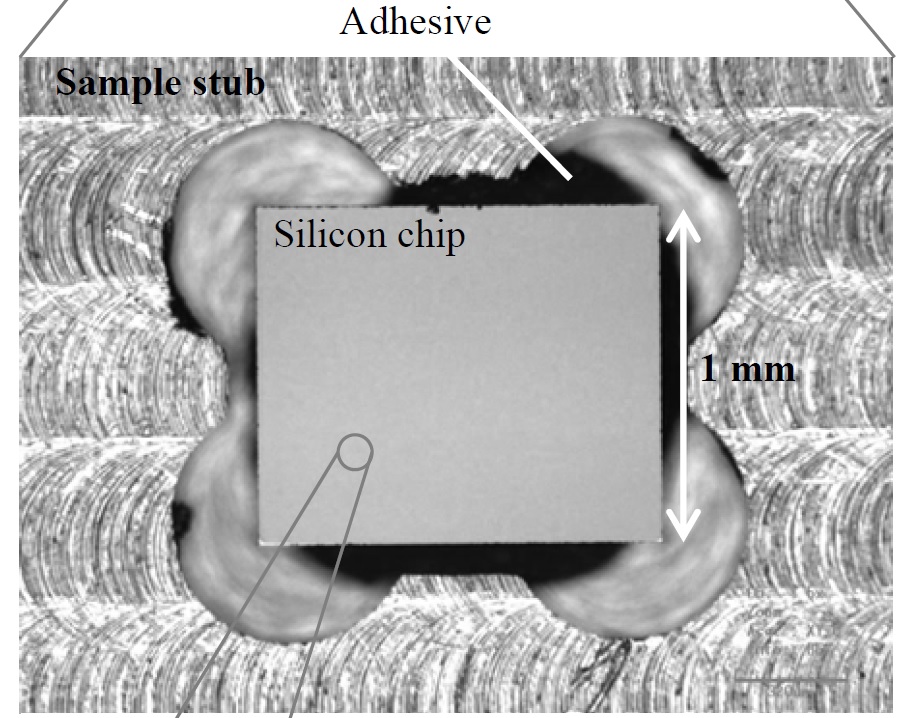 |
一次元回折格子は、半導体デバイス製造現場において測長走査電子顕微鏡の倍率校正に用いられる重要な標準試料の一つです。一次元回折格子のピッチ校正システムは、長期的な安定性が求められます。今回、産総研の測長原子間力顕微鏡を参照標準として、校正事業者の回折式ピッチ校正システム(光学式、X線方式)の校正・測定能力の再評価を行ったので報告します。
詳細はこちら |
CD-AFM用の多機能キャラクタライザを使用した探針特性評価方法 (Ultramicroscopy誌)(井藤)
|
CD-AFMチップに適用される多機能AFMチップキャラクタライザおよびメソッドを示します。この方法では必要なステップが少なく、結果は他の方法と比較して0.5 nm以内です。長さ標準トレーサビリティは、統合されたナノスケールピッチ機能を使用して実現できます。キャラクタライザが評価できるCDチップのタイプを指定するのに役立つシミュレーションを示します。
詳細はこちら |
ナノ材料計測のための走査電子顕微鏡法および関連標準物質に関する調査研究(産総研 計量標準報告)(熊谷)
|
EU諸国で開始されたナノ材料に関する規制を満たすために、最も人気のある表面可視化ツールである走査電子顕微鏡(SEM)は、個々のナノ粒子を直接観察し、その寸法を測定する機能により、ソリューションの1つになると予想されます 。 このレポートは、SEMでの倍率キャリブレーションと画像解像度の評価に焦点を当てた、ナノ材料測定ツールとしてのSEM技術の最近の状態を示しています。 試料汚染と電子検出器の評価も、ナノ材料測定の重要な問題として議論されています。
詳細はこちら |
測長原子間力顕微鏡を用いたプロファイル表面粗さ測定および不確かさ評価 (Measurement誌)(三隅)
|
表面粗さの測定は、薄膜作製および材料表面処理の条件を評価するために、原子間力顕微鏡(AFM)を使用して実行されることがあります。 最近、薄膜と材料表面の両方の品質をさらに向上させるために、正確で信頼性の高い表面粗さ測定が必要になりました。 AFM探針形状の評価方法は、AFMを使用した表面粗さ測定の重要な技術です。 探針評価試料を用いたAFM探針形状の評価方法とその評価基準は、JIS R 1683:2007「原子間力顕微鏡によるセラミック薄膜の表面粗さの試験方法」に規定されています。 本研究では、JIS R 1683:2007に基づいてプロファイル表面粗さ測定を実施し、測定結果を報告します。
詳細はこちら |
世界最小の「ものさし」を実現 (NEDO実用化ドキュメント 取材日2013/12-2014/2)(三隅)
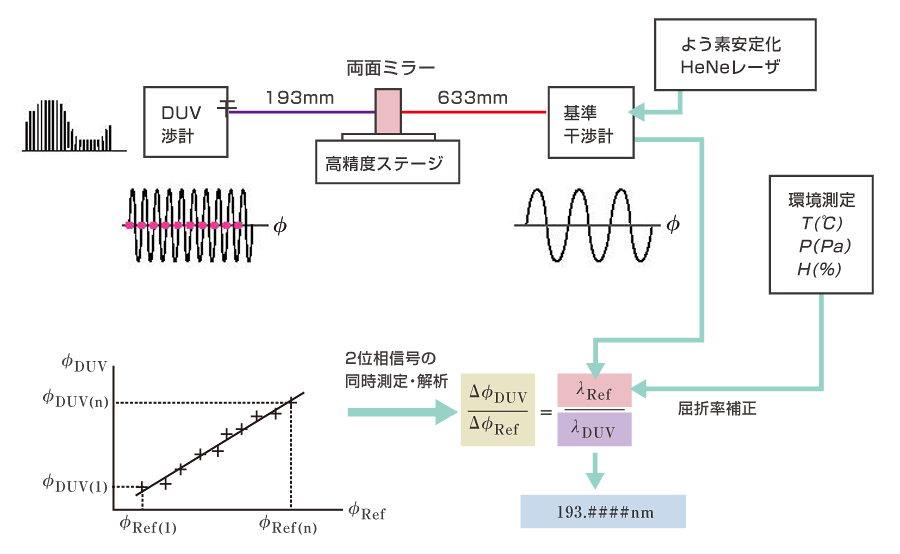 |
国の計量標準を担っている独立行政法人産業技術総合研究所・計量標準総合センター(以下、NMIJ)は、100 nm間隔の「ものさし」を開発した、株式会社日立製作所と株式会社日立ハイテクノロジーズの協力のもと、NEDOプロジェクトを通じて、100 nm間隔を、国際単位系の長さの定義に基づき、厳密に計測できる装置の開発に挑みました。
詳細はこちら |
電気走査プローブ顕微鏡法を用いた半導体デバイスのキャリア濃度の実験的定量化のための分析手順 (Measurement Science and Technology誌)(井藤)
|
走査型静電容量顕微鏡(SCM)は、原子間力顕微鏡の接触モードバリアントに基づいており、半導体デバイスの2次元キャリア(電子とホール)分布のイメージングに使用されます。シリコンや炭化ケイ素などの半導体材料用に作製された、実験的に推定された検量線によるキャリア濃度の定量化方法を導入しました。分析手順は、ラウンドロビンテストで研究機関に配布されました。この方法の有効性は、実際の分析と、ユーザ間の比較可能性の観点から、標準化に期待されるものについて確認されました。また、走査型拡散抵抗顕微鏡法や走査型非線形誘電顕微鏡法など、他の電気走査プローブ顕微鏡法にも適用されました。キャリア濃度の深さプロファイルは、SCMによって特徴付けられるプロファイルとよく一致することがわかりました。これらの結果は、提案された方法が将来の次世代顕微鏡法と互換性があることを示唆しています。
詳細はこちら |
走査型静電容量顕微鏡法によるCIGS太陽電池のキャリア濃度の特性評価 (Measurement Science and Technology誌)(井藤)
|
高効率の太陽電池材料用に設計されたセレン化銅インジウムガリウム(CIGS)の薄膜を調べて、走査型静電容量顕微鏡(SCM)を使用して2次元キャリア分布を特徴付けました。断面サンプルの調製方法を最適化したところ、25°から30°のベベル研磨は、CIGSなどの砕けやすい多結晶材料に効果的であり、ひびの入った結晶粒の表面特性ではなく、個々の切断粒の断面特性を提供することが分かりました。この準備手順が改善されたため、100 Wハロゲンランプの照射をオンにする前後に、アクティブなCIGS層でキャリア分布の変化が直接観察されました。 CIGSのNの相対値を定性的に計算するために、キャリア濃度NとSCMのdC / dV信号間の検量線を適用しました。 粒子上のキャリア濃度のピークの増加は、光を当てた場合の約3倍になると推定されました。
詳細はこちら |
半導体デバイス用途向けのSPMシステム (Microscopy誌)(井藤)
|
最近、半導体デバイスの開発に走査型プローブ顕微鏡(SPM)が広く使用されています。 SPMの重要な機能の1つは、ナノスケールデバイスの形状やフィルムの表面粗さなどの高解像度トポグラフィーです。 さらに、SPMはナノスケールデバイスの電子構造を測定できます。 薄膜用のSPMシステムは、デバイスアプリケーション用の薄膜を特徴付けるために開発されました。
詳細はこちら |
原子間力顕微鏡により測定された表面粗さの精度を評価および改善するためのシミュレーション研究 (Measurement Science and Technology誌)(井藤)
|
原子間力顕微鏡(AFM)による表面粗さ測定の精度の定量的かつ正確な評価は、分析的アプローチで探針と試料の膨張によって影響を受ける測定値を定式化するのが難しいため、十分に達成されていません。この研究では、シミュレーション結果から、ガウス粗面の表面粗さの測定に対する探針と試料の膨張の影響を一般化および定式化する可能性を探ります。探針の有効幅と表面の相関長の比として定義される正規化された探針幅wNを導入することにより、正規化された二乗平均平方根粗さSqNとwNの関係および正規化された相関長SalNおよびwNが導出されました。さらに、侵食アルゴリズムをガウスの粗い表面のAFM画像に適用しても、より良い粗さ測定は得られず、その結果は、AFM画像の歪度に対する探針と試料の膨張の影響に関連することがわかりました。さらに、画像の歪みを利用して10%未満の誤差内で真の粗さを迅速に推定する、ガウス粗面の単純で効果的な推定式を提示しました。この研究は、AFMを使用して正確な粗さ測定を達成するのに役立ちます。
詳細はこちら |
トレーサブルX線回折計と測長原子間力顕微鏡の25 nmピッチ比較測定 (Measurement Science and Technology誌)(三隅)
|
一次元グレーティング(1D-grating)は、CD-SEMなどのナノ計測機器を校正するための最も重要な参照標準の1つです。 最近、ナノ計測機器の解像度が高くなり、ピッチの小さい1D-gratingが必要になりました。 この要求に基づいて、Si / SiO2多層薄膜構造で構成される25 nmピッチの1D-gratingが開発されました。 さらに、測長原子間力顕微鏡(計測AFM)およびX線回折計を使用したピッチ校正が適用されています。長さと角度の標準にトレーサブルなX線回折計と測長AFMの25 nmピッチ比較の結果が報告します。
詳細はこちら |
一次元回折格子のピッチ校正範囲を拡張 (産総研TODAY 2011.07)(三隅)
 |
産総研は、多層膜構造からなる一次元回折格子(ピッチ公称値:25ナノメートル、繰り返し:40周期)を開発し、測長AFMでピッチ校正を行いました。ピッチ校正の不確かさ評価において、これまで過大評価となっていた項目を是正し、また産総研計量標準総合センターが開発した分散分析プログラム(AIST-ANOVA)を新たに用いることにより、これまでより一桁小さな不確かさ(数十ピコメートルオーダー)を得ることができました。また産総研は、ドイツの国家計量標準機関である物理工学研究所(PTB)との間で、それぞれが保有する測長AFMを用いて、ピッチ比較測定を行い、図のように良好な結果を得ました。本比較測定結果をもとに今回、産総研は、ピッチ校正サービスの範囲を最小23ナノメートルまで拡張しました。
詳細はこちら |
ナノ構造を精密に測る-原子間力顕微鏡用の標準物質と精密形態計測- (産総研TODAY 2010.08)(井藤)
|
形状誤差を取り除いた、高精度なナノ計測を実現するため、標準物質を利用した探針形状計測システムや、走査システム校正用標準物質の作製方法を開発しました。開発したナノ構造作製プロセスでは、5 nm線幅(ハーフピッチ)までの寸法領域において、1 nmの精度(バラツキ)をもつ標準試料を作製できます。
詳細はこちら |
測長原子間力顕微鏡を用いた25 nmピッチ面内方向スケールの二国間比較(Measurement Science and Technology誌)(三隅)
|
一次元(1D)および二次元(2D)グレーティングは、ナノ計測機器の校正のための最も重要なトランスファー標準の一つです。国家計量標準機関(NMI)は、国際的な比較を通じて校正能力を実証し、顧客にピッチ校正サービスを提供します。過去には、4000 nm、1000 nm、700 nm、300 nmなどの大きなピッチのグレーティングについて国際比較が3回行われていました。さらに、日本の産総研計量標準総合センター(NMIJ)とドイツの物理工学研究所(PTB)の間で、100 nmと50 nmの二国間比較が行われました。しかしながら、産業界では、ピッチをますます小さくするための校正サービスが必要です。以前の研究で、NMIJは面内方向スケール、つまりSi / SiO2多層薄膜構造で構成される25 nmピッチの特別な一次元グレーティングを開発し、レーザ干渉計を備えたNMIJの原子間力顕微鏡を使用してこのスケールのピッチを校正しました。本研究では、NMIJとPTBの間の面内方向ナノスケールの非公式の二国間比較の結果を報告します。
詳細はこちら |
Si/SiO2多層薄膜構造による面内方向ナノスケールの開発および分散分析を用いた不確かさ評価の改善(Measurement Science and Technology誌)(三隅)
|
Si/SiO2多層薄膜構造を持つ面内方向ナノスケール(設計ピッチ:25 nm)が開発されました。 開発した面内方向ナノスケールのピッチは、差動式レーザ干渉計を備えた原子間力顕微鏡を使用して校正され、ピッチ測定の不確かさが評価されました。 不確かさの評価では、過大評価を避けるために2つの評価方法が改訂されました。 分散分析は、スケールの不均一性および同じ測定場所での測定の再現性に起因する不確かさの評価に適用されました。 拡張不確かさ(k = 2)は、本研究では29〜154 pmとなり、以前の研究での0.43 nmより小さくなりました。
詳細はこちら |
GaAs / InGaP超格子の面内方向ナノスケールへの応用(Measurement Science and Technology)(三隅)
|
産総研(AIST)計量標準総合センター(NMIJ)は、原子間力顕微鏡(AFM)および走査電子顕微鏡(SEM)校正用のGaAs / InGaP超格子(多層)で構成される面内方向ナノスケール(設計ピッチ:25 nm)を開発しました。 作製された面内方向ナノスケールのピッチは、差動式レーザ干渉計を搭載したAFM(DLI-AFM)を使用して測定され、ピッチ測定の不確かさが評価されました。 平均ピッチとその拡張不確かさ( k = 2)は、それぞれ25.39 nmと0.43 nmでした。 開発されたスケールの品質は、CRMの適切な候補となるほど十分に高いことが確認されました。 この研究で得られた結果に基づいて、面内方向ナノスケールの製造手順とレイアウトは、これらのスケールの将来の頒布のために最適化されます。
詳細はこちら |
ナノメートルの世界で超精密なものさしを実現 (産総研TODAY 2007.05)
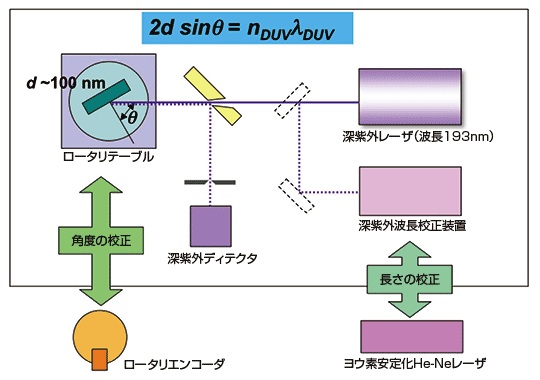 |
今回、私たちは、経済産業省、新エネルギー・産業技術総合開発機構(NEDO)や日本品質保証機構の協力を得て、最小で97ナノメートルの目盛りまで計測と校正ができる、深紫外レーザを用いた回折式ピッチ校正装置を開発しました。波長193ナノメートルのパルスレーザを回折格子であるものさしに照射し、回折ビームの角度と波長を計測することにより、不確かさ0.04ナノメートルと、これまでにない精度で校正(値付け)することが可能になりました。ここまで不確かさを小さくできたのは、見えないレーザと波長633ナノメートルの基準レーザの比較校正装置を開発し、角度の目盛りの基準であるロータリーエンコーダーの精密校正、そして干渉や回折を起こすパルスレーザの信号を捕らえる高速信号処理技術を開発をできたからです。
詳細はこちら |
深紫外レーザ回折計、走査電子顕微鏡、さまざまな原子間力顕微鏡の間での100 nmおよび60 nmスケールのラウンドロビン測定 (Measurement Science and Technology誌)(三隅)
|
100 nm以下のピッチの一次元グレーティングを用いて深紫外(DUV)レーザ回折計、限界寸法走査電子顕微鏡(CD-SEM)、様々な種類の原子兼力顕微鏡を用いて、相互比較が実行されました。 参照値とその拡張不確かさは、差動式レーザ干渉計を備えた原子間力顕微鏡(DLI-AFM)を使用して、産総研計量標準総合センター(NMIJ)によって提供されました。 DUVレーザ回折計、CD-SEM、およびいくつかのAFMを使用して得られた測定結果の一貫性は満足のいくものでした。 ただし、いくつかのAFMを使用して得られた測定結果では不十分でした。 ナノ計測標準を使用したAFM校正技術の改善は、AFMメーカと計測機関を含むAFMユーザの両方に必要です。
詳細はこちら |
走査型プローブ顕微鏡の国際標準化 (Nanotechnology誌)(井藤)
|
特に国際標準化機構(ISO)および関連研究を通じて、非接触原子間力顕微鏡(NC-AFM)を含む走査型プローブ顕微鏡(SPM)のグローバル標準化を達成するための最近の取り組みが調査されています。 SPMの用語の統一は標準化の前提条件であるため、最初に優先順位を付け、次にデータ管理と処理を統一する必要があります。これにより、さまざまなタイプの機器によって収集されたSPMデータへのアクセスと処理が可能になります。 さまざまなSPM分析方法の中で、SPMの寸法測定は標準化の最優先事項と見なされています。 これには、2つの基本的な問題を解決する必要があります。x、y、およびz座標軸をSIの長さ単位にトレーサブルに校正し、プローブの先端の形状に起因する形態学的アーチファクトを排除します。 使用中に歪んだ画像を復元し、先端の形状を特徴付けるための事前標準化の取り組みについて説明します。
詳細はこちら |
原子間力顕微鏡用のチップキャラクタライザ(Review of Scientific Instruments誌)(井藤)
|
原子間力顕微鏡(AFM)のチップキャラクタライザは、多層薄膜の製造に基づいて開発されました。 櫛形のラインアンドスペース(LS)とウェッジ形のナイフエッジ構造がGaAs基板上に作成されました。 GaAs ∕ InGaP超格子を使用して構造の幅を正確に制御し、選択的化学エッチングを使用してナノ構造に鋭いエッジを形成しました。 LS構造の最小サイズは10nmになるように設計されており、ナイフエッジの半径は5nm未満でした。 これらのナノ構造は、AFM画像のラインプロファイルからカンチレバーの先端の形状を測定するための明確な先端特性評価として使用されました。
詳細はこちら |
直接トレーサブルなレーザ干渉計を備えた原子間力顕微鏡を使用した面内方向ナノスケールの開発 (Measurement Science and Technology)(三隅)
|
ナノ計測機器の校正には、サブナノメートルピッチの一次元グレーティング標準が必要です。 ナノ計測機器の校正用のナノメートルの横スケール(設計ピッチ:100、60、および50 nm)は、電子ビームセル投影リソグラフィによって設計および製造されました。 ヨウ素安定化He–Neレーザとスレーブレーザで構成されるオフセットロックレーザシステムは、連続的に直接長さ標準にトレーサブルなシステムを実現するために、差動式レーザ干渉計を備えた原子間力顕微鏡(DLI-AFM)に設置されました。 また、新しいDLI-AFMを使用して、面内方向ナノスケールのピッチを校正しました。 平均ピッチは設計ピッチに非常に近く、拡張不確かさ( k = 2)は設計ピッチの0.6%未満でした。 開発された面内方向ナノスケールは、十分に高品質であり、認証標準物質(CRM)の候補です。
詳細はこちら |
横方向寸法測定におけるAFMの圧電アクチュエータの非線形およびヒステリシスの影響 (Sensors and Actuators A: Physical)(三隅)
|
超高解像度3軸レーザ干渉計システムを搭載したリアルタイム測定「ナノ測長原子間力顕微鏡」システムが開発され、圧電アクチュエータの望ましくない特性が完全に補償されます。これは、ナノ計測の横スケールとして広く使用されている参照標準の1つであり、圧電アクチュエータの非線形特性とヒステリシス特性が画像再構成に及ぼす影響と横方向の寸法測定は、3つの異なる測定方法の間で定量的に比較検討されます。 3つの測定方法は次のとおりです。(1)プローブチップとサンプル間の相対運動は、XYZスキャナに印加される電圧信号によって直接制御および測定されます。圧電アクチュエータの非線形およびヒステリシス特性は補正されません。 (2)プローブチップとサンプル間の相対移動は、XYZスキャナーに印加される電圧信号によって制御されますが、干渉計によって正確に測定されます。 (3)プローブチップとサンプルの横方向の相対移動は、干渉計によって正確に制御および測定されます。比較結果によると、正確な変位制御システムは、圧電アクチュエータの望ましくない特性の影響を低減するための鍵であり、3軸レーザ干渉計システムを備えた開発されたAFMシステムは、圧電アクチュエータの非線形特性およびヒステリシス特性を完全に排除することが証明されています。
詳細はこちら |
段差試料に関連する基準直線のパラメータの信頼性:ナノ測長AFMを使用した段差測定の不確かさ評価 (Precision Engineering誌)(三隅)
|
段差は、ナノ計測機器の校正のための重要なナノ計測標準の1つとして広く使用されています。段差の計算では、基準直線を決定する方法が非常に重要です。寸法計測学の分野であるナノ計測では、通常、基準直線などの関連フィーチャ(ガウス関連フィーチャ)は、最小二乗法を使用して、実際のフィーチャ上の計測機器の測定データセットから計算されます。基準直線の信頼性は、ラインの測定ポイントの位置と数によって異なり、段差の校正の不確かさも基準直線の信頼性によって異なります。この研究では、3軸レーザ干渉計を備えた原子間力顕微鏡(AFM)を使用して、微細パターン薄膜(10、7、5、および3 nm)の段差測定を実行し、不確かさを評価しました。不確かさの評価結果から、基準直線のパラメータの信頼性から導き出された不確かさは、基準直線の測定点が変化したときの不確かさの主要な原因の1つでした。 0.4 nm未満の拡張不確かさ( k = 2)が得られました。さらに、原子ステップなどの片段差における関連する基準直線の信頼区間が計算され、不確かさ評価と測定戦略の決定において信頼区間の計算の重要であることが示されました。
詳細はこちら |
面内方向ナノスケールを設計するための差動式レーザ干渉計搭載型AFMを用いた100 nm以下ピッチ測定 (Measurement Science and Technology誌)(三隅)
|
差動式レーザ干渉計を備えた新しい原子間力顕微鏡(DLI-AFM)を開発し、DLI-AFMを用いて、100、80、60、50 nmのピッチのプロトタイプ一次元グレーティング標準のテスト測定を実施しました。ピッチ計算の手順では、「重心法」と「ゼロクロッシング法」の2種類のピーク位置の定義を比較しました。 ゼロクロッシング法によるピッチの標準偏差は重心法によるピッチの標準偏差よりも小さかったため、この研究ではゼロクロッシング法を採用しました。 拡張不確かさ( k = 2)は約0.20 nmで、公称ピッチ50 nmで0.4%でした。 認証標準物質として、使用可能な一次元グレーティング標準の設計を提案します。
詳細はこちら |
光回折計、走査電子顕微鏡、原子間力顕微鏡間のサブマイクロメートルピッチの相互比較 (Measurement Science and Technology誌)(三隅)
|
ナノメートルの横方向スケールで広く使用されている参照標準の1つである一次元グレーティング標準(240 nmピッチ)のピッチ測定の相互比較が、光回折計、限界寸法走査電子顕微鏡(CD-SEM)、測長原子間力顕微鏡の3つの異なる方法で実行されました。 3つの方法で得られた平均ピッチ値は、最大でわずか0.67 nmだけ相違し、拡張不確かさ( k = 2)は1.2 nm未満でした。 計算されたEn数、つまり測定品質の指標が1未満であることは、3つの方法で測定されたピッチ値と不確かさ分析の整合性を示しています。
詳細はこちら |
測長原子間力顕微鏡を使用した一次元グレーティング標準のピッチ測定の不確かさ (Measurement Science and Technology誌)(三隅)
|
240 nmピッチの一次元グレーティング標準の高精度測定は、高分解能3軸レーザ干渉計を搭載した原子間力顕微鏡(測長AFM)を使用して実行されました。 測長AFMの3軸レーザ干渉計のレーザ光源は、波長633 nmのヨウ素安定化He–Neレーザで校正されました。 測長AFMを使用した精密測定の結果は、長さ標準に対して直接トレーサビリティがあります。 ピッチ測定の不確かさは、計測における不確かさの表現ガイド(GUM)に従って推定されました。 測定における不確かさの主な原因は、干渉計の非線形性に由来し、その値は約0.115 nmでした。 0.31 nm未満の拡張不確かさ( k = 2)が得られました。測長AFMは、ナノ計測の標準の校正に役立つ機器であることが示唆されています。
詳細はこちら |
高分解能AFMによるナノメートル計測 (AIST Today 2002.01)(三隅)
 |
我々はXYZ三軸に高分解能レーザ干渉計を搭載した写真の原子間力顕微鏡(測長AFM)を開発し、信頼性の高い実時間測定を世界で初めて実現した。この測長AFMを用いて、市販のAFMや走査電子顕微鏡(SEM)の校正時に用いる一次元グレーティング(ナノ寸法スケール)標準試料の精密測定を行い、不確かさの評価を行った。
詳細はこちら |