スパッタリング装置/Sputter deposition system

全自動薄膜製造装置(直径100mm基板)。
最高基板温度500℃、多層膜プログラム、long-throughタイプのヘリコンカソード装備。
両面マスクアライナー/Mask Aligner

アライナ(直径100mm基板用)PEM800
裏面を合わせた露光可能。
PECVD-RIE

TEOSを用いた300℃SiO2製膜プロセス。
RIEドライエッチング。何れも全自動、8インチプロセス。
段差計/Step profiler

TENCOR
薄膜の厚み、表面粗さ等を計測。
比表面積/細孔分布測定装置/Surface area and pore size analyzer

BET比表面積や細孔分布を自動で迅速に分析
精密スクリーン印刷機/Precise screen printing machine

電極パターン等の製版を用いて、ペーストを基板に印刷する装置。画像解析機能を持ち、印刷の位置合わせを自動で行う。
高温熱電特性評価装置/High temperature thermoelectric properties measurement system

測定項目:導電率・ゼーベック係数
温度範囲:室温~1000℃
雰囲気:大気・O2・N2・Ar
極低温電気特性評価装置/Cryogenic electrical properties measurement system

測定項目:電気抵抗率・ゼーベック係数
温度範囲:7~350 K
雰囲気:真空
原子間力顕微鏡/Atomic Force Microscope
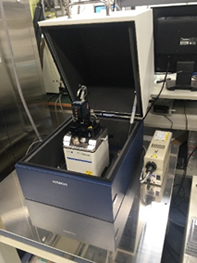
レーザフラッシュ法熱伝導率測定装置/Thermal conductivity measurement system

測定項目:熱拡散率・比熱
温度範囲:室温~1100℃
雰囲気:Ar
粉末冶金関連装置
- ガス置換用グローブボックス
- 遊星型ボールミル(~400rpm、大気、真空、不活性ガス)
- 通電焼結装置
熱電特性評価装置
- 電子負荷装置(熱電発電モジュール評価用、低電圧タイプ)
観察・評価装置
- 走査プローブ顕微鏡
共同利用設備
- FE-SEM
- XRD (Rigaku : Smart Lab)
