非破壊で内部クラックの評価を実現する技術
ー 半導体の高品質化に貢献 内部のクラックを見抜く技術 ー
研究のねらい
半導体デバイスの製造プロセスには、ウェーハを平坦にするための研磨工程があるが、この工程において、
従来の検査技術では検出困難な微小欠陥の一つである“潜傷(マイクロ・サブマイクロスケールのクラック)”を形成してしまうことがある。
潜傷は、半導体製品の品質に大きく影響するため、高感度な潜傷検出・判別技術が求められている。
半導体製造プロセス中で潜傷検出・判別を行うためには、非破壊的な検査技術が必須となる。
本研究では、潜傷の選択的検出を実現することを目的に、非破壊的な潜傷検出技術の開発を行っている。
主な成果
潜傷近傍の光学特性に着目し、ウェーハへ機械的応力や温度変化を与えることによって引き起こされる潜傷近傍の光学特性変化を捉えることによって、
潜傷の高感度かつ非破壊的な検出・判別を実現。
さらに、光散乱像と機械学習を組み合わせることによって、潜傷の深さの非破壊的な解析に成功。
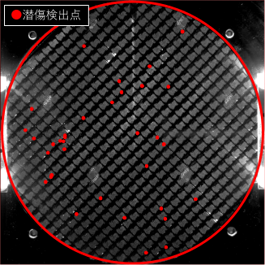
ウェーハ全面における潜傷の検出に成功

機械学習によって潜傷の深さを予測
用途・展開先
半導体デバイス製造中のウェーハの評価技術