半導体プロセスインフォマティクスを実現する技術
ー スマート半導体製造センシング技術 ー
研究のねらい
半導体製造において、CMPなどの精密研磨プロセスにおいて、潜傷(エッチング後に初めて分かる微小クラック)を検出・判別する事は、大変重要です。
そのためには、ウエハーに影響を与えない非破壊・非接触の検査技術が必須です。
本研究では、潜傷の選択的検出技術、CMPプロセスモニタリング技術、AIによる潜傷識別技術を開発し、製造プロセス最適化に導くプロセスインフォマティクスを目指します。
主な成果
1.ウエハーへ熱ひずみ(数度の温度変化)や機械的応力を印加し、潜傷近傍にのみ起こる光学特性変化を検出する事で、パターンやパーティクルの中から、潜傷の選択検知に成功
2.Alを活用し、一枚の画像から、潜傷3Dマッピング創生を検証
3.アクティブなAE(アコースティックエミッション)信号を活かして状態スペクトルを取得する白色アクティブ振動スペクトル(WAVS)技術を開発。CMP製造プロセスモニタリングを開始。
2.Alを活用し、一枚の画像から、潜傷3Dマッピング創生を検証
3.アクティブなAE(アコースティックエミッション)信号を活かして状態スペクトルを取得する白色アクティブ振動スペクトル(WAVS)技術を開発。CMP製造プロセスモニタリングを開始。

8インチウエハー潜傷(1μm以下)の選択的・非破壊診断
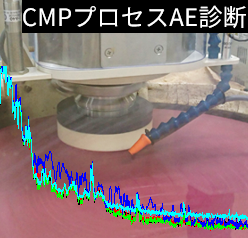
CMPプロセスモニタリング(AE診断)

ガラス潜傷(数10um)の3Dマッピング
用途・展開先
半導体ウエハー(Si, SiC, GaN)、精密研磨ガラス
潜傷評価技術、研磨プロセスモニタリング、プロセス最適化
潜傷評価技術、研磨プロセスモニタリング、プロセス最適化